英特尔对High NA EUV的真实看法
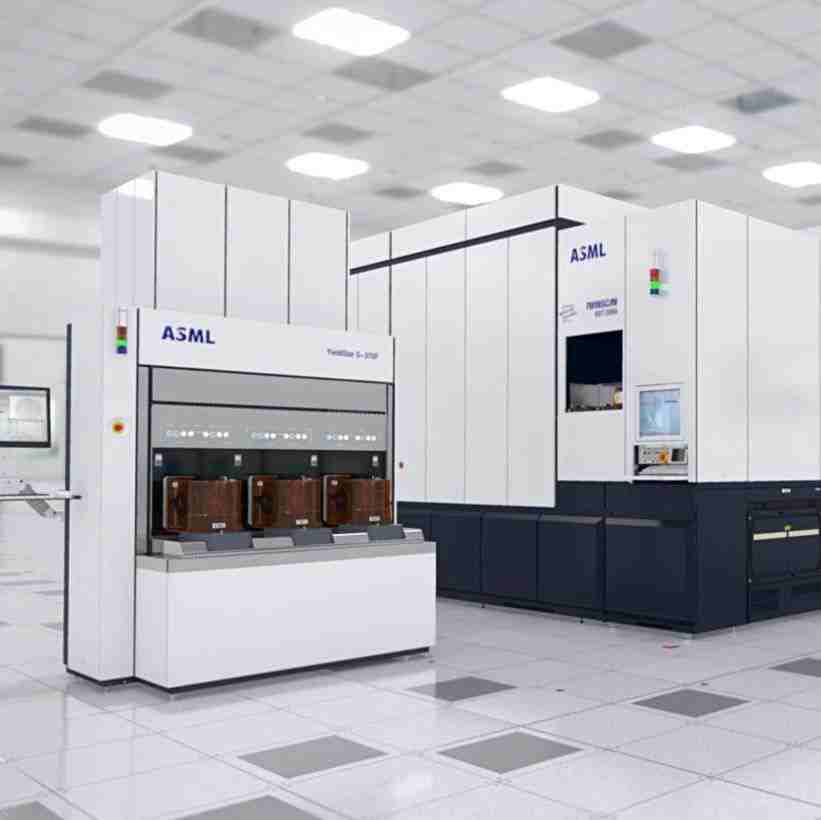
👆如果您希望可以时常见面,欢迎标星🌟收藏哦~
来源:内容由半导体行业观察(ID:icbank)编译自semiwiki,谢谢。
日前,英特尔与英特尔院士兼光刻总监 Mark Phillips 就采用High NA EUV 举行了新闻发布会。
1976 年,英特尔在俄勒冈州建造了 Fab 4,这是加州以外的第一家英特尔工厂。随着 300mm 晶圆厂的推出,俄勒冈州成为英特尔唯一一个拥有大型制造、开发和探路工厂的开发基地。
据介绍,俄勒冈州 Ronler Acres 工厂是 RP1、研究和寻路晶圆厂以及开发晶圆厂 D1C、D1D 和三个 D1X 模块的所在地,并计划增加一个模块,还计划在该地点重建一座旧晶圆厂。这些开发工厂或模块中的每一个都与其他一些公司的生产工厂的规模相似,使英特尔能够开发一种工艺,然后在同一工厂中将其投入初始生产。然后该工艺被复制到“生产”工厂。
英特尔首款基于 EUV 的工艺是 i4,于去年投入生产。i4在俄勒冈州开发,然后转移到爱尔兰的Fab 34进行大批量生产,转移到Fab 34进行得“非常顺利”。
Intel 18A工艺目前正在开发中,High NA工艺正在为未来的14A工艺开发。图 1 展示了英特尔的工艺路线图。
纵观半导体行业的历史,人们一直在不断提高工艺密度,以在同一面积上实现更多晶体管。实现更高密度的第一步是缩小平版印刷的特征。图 2 说明了曝光系统的演变以及由此产生的分辨率。
在图 2 的左下角,我们可以看到光学系统分辨率的公式(瑞利准则)。
- CD是临界尺寸,基本上是可以解决的最小特征。请注意,可实现的间距将是该数字的两倍。
- K1 是与工艺相关的因素,通常范围在 0.75 到 0.25 之间,并且通常随着工艺的成熟而变小(较小的 k1 等于较小的特征尺寸)。
- λ 是暴露辐射的波长。在最早的曝光系统中,汞弧灯被用作光源,G线(436nm)和I线(265nm)是指汞弧灯输出光谱中的峰值。KrF (248nm) 和 ArF (193nm) 是指在激发态下结合氪 (Kr) 惰性气体和氟 (F) 反应气体或氩 (Ar) 惰性气体和 F 反应气体的准分子激光器 - 在准分子激光器(激发二聚体),这些激发二聚体衰变分别发出 248 nm 或 193 nm 的光。ArFi是指ArF沉浸式,也是193nm。EUV 引入了一种光源,该光源使用二氧化碳激光器汽化锡滴,产生 13.5nm 光。与 k1 一样,波长越小,可解析的特征尺寸越小。
- NA 是光学器件的数值孔径,是镜头接收角的度量。NA 越高,收集的反射越多,因此信息越多/分辨率越高。较高数值孔径的系统通常需要更复杂的光学器件,对于大直径镜头来说尤其困难。在空气中可达到的最大 NA 为 1.0,ArF 干燥系统的 0.93NA 是曝光系统中达到的最高值。ArFi(ArF 浸没)是指在透镜和晶圆之间使用超纯水,这使得 ArFi 系统的NA 为 1.35,而 ArF 干式系统则在空气中进行曝光。NA 越高,可解析的特征越小。
高数值孔径有望简化工艺流程、提供更好的良率和更灵活的设计规则。
第一个高数值孔径工具原型位于 ASML 工厂。英特尔于 2024 年 1 月获得了第二个High NA 工具,见图 3。
该系统以未集成的方式运送到英特尔,仅比 ASML 的工具晚几周才完成集成。
High NA工具(标准EUV工具为0.55NA,而标准EUV工具为0.33NA)与0.33NA工具共享尽可能多的模块,例如激光源和晶圆模块与新的NXE:3800 0.33NA工具相同。高数值孔径工具的主要发展是光学,有大量数据表明这些模块符合规格,并且英特尔作为先行者与蔡司(蔡司制造光学器件)和 ASML 有着非常密切的关系。Mark 表示,他相信在 0.33NA 工具需要太多多重图案之前,High NA 工具将会可用。
我问Intel 18A 工艺是否有多重图案化,他说有一些,不是为了分辨率,而是为了切割以实现紧密的尖端到尖端间距。
英特尔相信,他们具有独特的优势,可以通过以下方式充分利用该工具:
Power via.
Internal mask shop.
Directed Self Assembly for defect repair.
Using advanced illumination with advanced mask to push limits.
Pattern shaping with directional etch (possibly Applied Materials Sculpta tool?).
高数值孔径工具的首个光源已经在 ASML 工厂实现,英特尔的首个光源也将“很快”实现。计划于 2025 年开发使用High NA 的 14A 工艺,英特尔正在 ASML 的工具上进行一些工作,以加快开发速度。
高数值孔径工具的考虑因素之一是尺寸和是否有可以容纳它的洁净室。图 4 显示了深 UV、EUV (0.33NA) 和高 NA EUV 系统的相对尺寸。
从图4我们可以看到,原来的0.33NA EUV系统比DUV系统大得多,事实上,洁净室的设计必须适应EUV系统。如果您进入配备 EUV 系统的晶圆厂,很容易发现它们,因为工具上方有一台起重机用于维护工作。例如,英特尔拥有许多较旧的晶圆厂,如果不对建筑结构进行重大修改,就无法容纳 EUV 系统。High NA 系统比 0.33NA EUV 系统更大。有趣的是,英特尔的 Fab D1X 和 Fab 42 均设计用于容纳 450mm 设备,因此应该具有高 NA 工具功能。英特尔所有刚刚竣工或正在建设的新工厂大概都具备高数值孔径能力。
目前的High NA 工具是 NXE:5000 开发系统,量产的High NA 工具将是 NXE:5200,Mark 提到在 NXE:5200 之后至少还会有三代High NA 工具。14A 计划在 18A 两年后投入生产,这意味着英特尔需要在 2026 年和 2027 年开始接收 NXE:5200 系统。
有一些关于 NA 可能为 0.75 的 Hyper NA 工具的讨论。Mark 提到,ASML 为 0.55NA 工具开发的很多东西都可以用于 0.75NA,并且该工具将与 0.55NA 工具尺寸相同。0.75NA 工具的潜在应用是互连,但其经济性尚未得到证实。
高数值孔径的另一个方面是变形设计,一个方向缩小 4 倍,另一个方向缩小 8 倍。当您采用当前的 6 英寸掩模版时,考虑到边缘排除,缩小了 8 倍,芯片尺寸受到限制,对于某些大型芯片,可能需要缝合,这需要考虑芯片上的缝合位置。英特尔正在推动新的 6” x 12” 掩模,以提高生产率,以实现无需缝合的大型芯片。
电话会议上没有讨论这一点,但一个关键问题是High NA 超过 0.33NA 能带来多少好处。我对High NA EUV 单次曝光与 0.33NA EUV 的 LESLE 双曝光进行了详细模拟,结果显示成本降低了 10% 以上,此外还有周期时间、良率和设计规则优势。
ASML 最近宣布,他们将第三套高数值孔径 EUV 系统交付给一位未公开的客户,尽管有传言称该系统交付给了台积电。英特尔一直是对采用高数值孔径最直言不讳的公司,但很明显,至少有一个竞争对手正在紧随英特尔之后对其进行评估。
原文链接
https://semiwiki.com/semiconductor-services/344572-intel-high-na-adoption/
点这里👆加关注,锁定更多原创内容
END
*免责声明:本文由作者原创。文章内容系作者个人观点,半导体行业观察转载仅为了传达一种不同的观点,不代表半导体行业观察对该观点赞同或支持,如果有任何异议,欢迎联系半导体行业观察。
今天是《半导体行业观察》为您分享的第3747期内容,欢迎关注。
推荐阅读
『半导体第一垂直媒体』
实时 专业 原创 深度
公众号ID:icbank
喜欢我们的内容就点“在看”分享给小伙伴哦
最新评论
推荐文章
作者最新文章
你可能感兴趣的文章
Copyright Disclaimer: The copyright of contents (including texts, images, videos and audios) posted above belong to the User who shared or the third-party website which the User shared from. If you found your copyright have been infringed, please send a DMCA takedown notice to [email protected]. For more detail of the source, please click on the button "Read Original Post" below. For other communications, please send to [email protected].
版权声明:以上内容为用户推荐收藏至CareerEngine平台,其内容(含文字、图片、视频、音频等)及知识版权均属用户或用户转发自的第三方网站,如涉嫌侵权,请通知[email protected]进行信息删除。如需查看信息来源,请点击“查看原文”。如需洽谈其它事宜,请联系[email protected]。
版权声明:以上内容为用户推荐收藏至CareerEngine平台,其内容(含文字、图片、视频、音频等)及知识版权均属用户或用户转发自的第三方网站,如涉嫌侵权,请通知[email protected]进行信息删除。如需查看信息来源,请点击“查看原文”。如需洽谈其它事宜,请联系[email protected]。